LED封装的功能主要包括:
1. 机械保护, 以提高可靠性; 2. 加强散热, 以降低芯片结温, 提高LED性能; 3. 光学控制, 提高出光效率, 优化光束分布; 4. 供电管理, 包括交流/ 直流转变, 以及电源控制等。
LED封装是一个涉及到多学科( 如光学、热学、机械、电学、力学、材料、半导体等) 的技术。(如图1所示)从某种角度而言,LED封装不仅是一门制造技术(Technology), 而且也是一门基础科学(Science), 优秀的封装工程师需要对热学、光学、材料和工艺力学等物理本质有深刻的理解。最近芯片级封装CSP吸引了大家的目光,所以现在与未来的LED封装技术,更需要在LED封装设计上与芯片设计上同时进行, 并且需要对光、热、电、结构等性能统一考虑。在封装过程中, 虽然材料( 散热基板、荧光粉、灌封胶) 选择很重要, 但封装结构( 如热学界面、光学界面) 对LED光效和可靠性影响也很大, 大功率白光LED封装必须采用新材料, 新工艺, 新思路。小间距或Mini LED的封装技术需要对倒装芯片与回流焊或共晶倒装封装制程更深刻的理解。对于LED的技术从业者而言, 成本光效与可靠度之外,更是需要将光源、散热、供电和灯具等集成考虑。本篇白皮书针对LED封装技术的现状与未来做探讨,进而分析未来LED封装的技术与产品趋势。

图1 LED 封装的组成要素。
LED封装方法、材料、结构和工艺的选择主要由芯片结构、光电/ 机械特性、具体应用和成本等因素决定的。经过40多年的发展,LED封装先后经历了支架式(LampLED)、贴片式(S MD LED)、功率型LED(Power LED)与COB等发展阶段。如图2 所示。
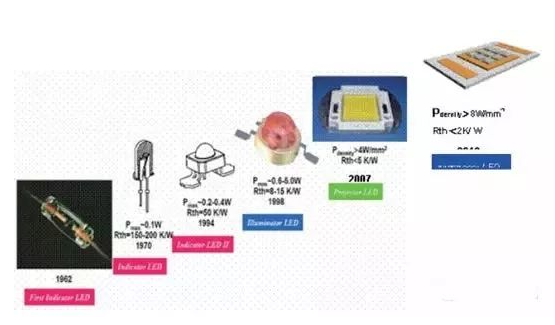
图2 LED 封装不同发展阶段的封装形式
发展到今天,往后会走向何方?SMD? EMC? COB?还是CSP? 什么是倒装焊与无封装?到底LED的封装会走那个方向,目前还是众说纷纭。不过从历史趋势来看,如图3所示,封装材料越来越少,材料导热性越来越好,功率密度越来越大,封装制程步骤来越精简与器件越来越少是未来的趋势,当然这离开不了芯片技术的进步。
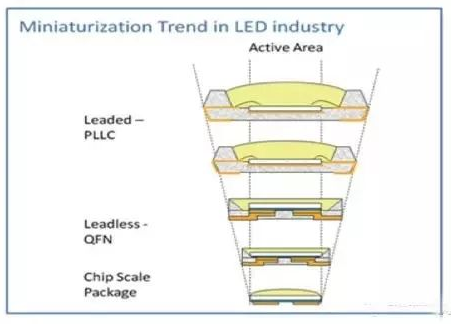
图3 封装制程步骤的精简趋势
表1是科技部半导体照明中心的中国LED的技术蓝图,从2004年开始到现在,中国一直往这个蓝图方向走,预计到未来的2022年将达到300流明瓦的目标,单灯成本将小于10块钱,这对封装技术而言是一项非常大的挑战,技术进步,成本降低,海兹定律未来会继续主导LED的方向,尤其是LED照明产业。过去十年,LED芯片效率的提升将使芯片的面积不断减小,进而驱动了LED封装革命,如表2所示。

表1
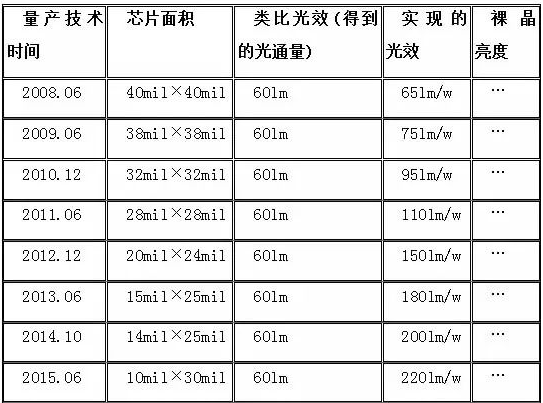
表2 LED芯片效率的提升将使芯片的面积不断减小
未来芯片技术将会以提高效率降低成本为主,莹光粉技术将以提高效率稳定性与演色指数为进步方向,LED芯片效率的提升将以阶段性成长为主, 从10lm/w~80lm/w、80lm/w~100lm/w、100lm/w~150lm/w、150lm/w~200lm/w…… 当技术进步到300lm/w时对比现有的芯片效率提升了1.5~2倍,芯片的发热量将大幅度减少( 指同体积同面积比较),这将导致目前各种封装技术进行大比拼,所有的技术路线趋势将会更分化与多元,什么产品使用什么封装工艺将会更固定。LED将迎来主流中有多元,多元分化但离开主流却不远。
随着芯片功率密度的不断增大, 特别是半导体照明技术发展的需求, 对LED封装的光学、热学、电学和机械结构等提出了新的、更高的要求。
由前文所叙述得知,高光效技术的发展路线可以预见现有的封装工艺与封装材料并不能适用于未来的封装要求。由于芯片内量子效率的提升所以产生的热量会减少,芯片有源层的有效电流密度会大幅度上升。芯片整体发热量减少了,所以对于封装形式的散热面积要求也会减少, 目前采用的厚重散热的封装结构将会发生大的变化,所以LED芯片效率提高使芯片面积大幅度减小,从而改变封装的方式,使单一器件的光输出大大增加,现在,单颗高效率LED芯片面积大幅度减小(250mil2=60LM)。发热变少与应用上对单一LED光源的高光通量需求使集成化封装成为主流。集成化封装LED器件的热聚集效应使LED器件的整体导热效率变得极为重要。能够大幅度减低热阻的封装技术可能成为LED芯片封装技术的主流,倒装的回流焊技术只要解决芯片良率与成本问题,这将会革命性的减低封装的成本,会使非金线焊接技术的倒装封装技术大规模应用。当然仿PC硬度的硅胶成型技术、非球面的二次光学透镜技术等出光技术都将成为LED封装技术的基础。定向定量点胶工艺、图形化涂胶工艺、二次静电喷莹光粉工艺、膜层压法三基色荧光粉涂布工艺、芯片沉积加压法等白光工艺都将应用在LED封装工艺中,将会改善LED器件的出光效率与光色分布。
1.SMD的发展趋势
SMD封装, 是Surface Mounted Devices的缩写, 意为:表面贴装器件, 它是SMT(Surface Mount Technology 中文: 表面黏着技术) 元器件中的一种。目前SMD是封装技术的最大宗产品,尤其是2835型的封装型式目前几乎占据了主流照明市场,预测未来五年内SMD还会是LED的主流,但是会逐步降低比率,但是维持半壁江山还是有机会的,未来SMD会有下列趋势迎接其它技术的竞争:
a) 中功率成为主流封装方式。目前市场上的产品多为大功率LED产品或是小功率LED产品,它们虽各有优点,但也有着无法克服的缺陷。而结合两者优点的中功率LED产品应运而生,成为主流封装方式。
b) 新材料在封装中的应用。由于耐高温、抗紫外以及低吸水率等更高更好的环境耐受性, 热固型材料EMC(Epoxy Molding Compound)、热塑性PCT、改性PPA以及类陶瓷塑料等材料将会被广泛应用。
c) 相较于PPA或是陶瓷基板,EMC封装方案为采用环氧树脂材料为主,更容易实现大规模的量大生产需求,透过量的扩增进一步压缩制造成本,另外环氧树脂材料应用更为弹性,不仅尺寸可以轻易重新设计,加上材料更小、更容易进行切割处理,终端产品元器件的设计更为灵活、弹性,所制成的终端光源组件可在小体积上驱动高瓦数,尤其在0.2W~2W左右的光源产品极具竞争力。
目前COB应用逐渐得到普及,凭借低热阻、光型好、免焊接以及成本低廉等优势,COB应用在今后将会继续渗透。COB封装工艺有非常多的优势,甩掉了支架表贴焊接这个环节,COB封装工艺是直接将LED裸芯片固定到焊盘上,所以散热面积相对传统封装工艺要大,材料综合热传导系数也高,散热性好。这也是保证COB封装高可靠性因素中权重最高的一个因素。COB封装省去了灯珠面过回流焊工艺,不再造成传统封装工艺回流焊炉内高温对LED芯片和焊线失效。另外可以跟其它元器件集成封装式的光引擎也是COB的很大优势,集成封装式光引擎也许会是未来COB技术的主流之一。
SIP(System in Package) 是近几年来为适应整机的便携式发展和系统小型化的要求, 在系统芯片 System on Chip(SOC) 基础上发展起来的一种新型封装集成方式。对SIP-LED而言, 不仅可以在一个封装内组装多个发光芯片,还可以将各种不同类型的器件( 如电源、控制电路、光学微结构、传感器等) 集成在一起, 构建成一个更为复杂的、完整的系统。同其他封装结构相比,SIP具有工艺兼容性好( 可利用已有的电子封装材料和工艺), 集成度高, 成本低, 可提供更多新功能, 易于分块测试, 开发周期短等优点。当然COB在光效与发光密度的参数也是大家比较关注的焦点,根据报导,在Ra>80,R9>0的高光色质量下,目前国内COB最高光效的数据高达162lm/W,最高流明密度可以到达88lm/mm2,但是在105lm/W的光效之下,流明密度更可以达到220lm/mm2,与美国的cree的280lm/mm2还是有不小的差距,但是已经接近国际大厂的水平。
3.CSP 的发展趋势
CSP的全名是芯片级封装(Chip Scale Package),就是目前封装业界最怕的无封装制程,如图4 所示,CSP无需支架、金线等传统封装工艺中必须的主要部件材料及固晶、焊金线等封装主要装备。CSP的技术定义为将封装体积和LED芯片一致、或是封装体积应不大于LED芯片20%,且LED仍能具备完整功能的封装器件,而CSP技术所追求的是在器件体积尽可能微缩、减小,却仍须维持相同芯片所应有的光效,而关键器件体积减小后最直接的特点就能实践低成本、小发光面积、更长组件使用寿命的设计目的,再加上小体积器件也表示二次光学的相关光学处理优化弹性更高、处理成本更低,制成的灯具产品能在极小光学结构实践最高亮度与最大发光角度。
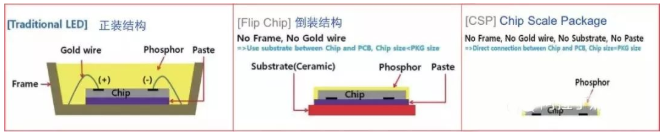
图4
CSP发展到现在,如图5所示,技术路线始终有两个方向,单面发光与五面发光,三星LED发展CSP之初,是为了大尺寸背光用途,使用技术比较简单的五面发光技术,同样的技术路线是首尔半导体的WICOP,用来应用于通用照明市场。单面发光技术有日亚与亮锐的CSP产品,由于是单面发光,所以工艺比较复杂,需要在器件的侧面镀反射膜,成本会比较高,但是此产品可以用于高阶的应用例如汽车照明与手机照相的闪光灯,所以目前是CSP技术的未来趋势。
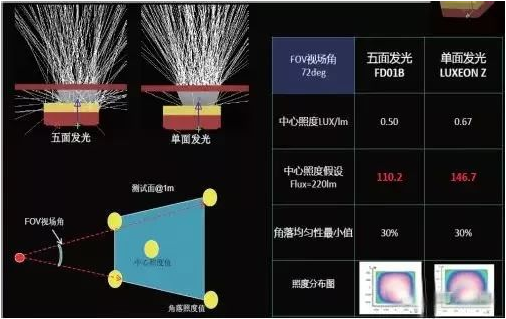
图5
如图6所示,目前日亚化学在单面发光CSP技术处于领先地位,单面发光技术相对与SMD,除了价格目前比较高以外,有非常绝对的优势,可以用在特殊照明的市场应用,例如电子产品的手机照相机闪光灯与液晶背光,汽车大灯,户外照明的路灯隧道灯与投光灯,以及高密度COB产品都可以使用。未来随着大批量CSP制造技术成熟,CSP会持续渗透到更多的照明应用。
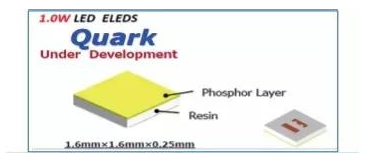
图6
目前国内厂商的CSP的亮度表现已经接近日韩水平,市面上可以量产1W级的光效可以到达205lm / W(350mA,cRI 80+,5000K),3W级的产品也可以达到190lm/ W(750mA,cRI 70+,5000K) 的光效,5W封装技术可以到达170lm/ W(1200mA,CRI70+,5000K)的光效。性价比更是甩开日韩相关产品,但是由于品牌与专利的关系,目前主流应用例如汽车照明或闪光灯市场还是很难进入。
1) 芯片超电流密度会继续增加。
今后芯片超电流密度,将由0.5mA/mil2 发展为1mA/mil2,甚至更高。而芯片需求电压将会更低,更平滑的VI曲线( 发热量低),以及ESD 与VF 兼顾。
2) 适用于情景照明的多色LED光源。
情景照明将是LED照明的核心竞争力,而未来LED照明的第二次起飞则需要依靠情景照明来实现。
3) 光效需求相对降低,性价比成为封装厂制胜法宝。
今后室内照明不会太关注光效,而会更注重光的品质。而随着封装技术提高,LED灯具成本降低成为替代传统照明源的动。
4) 去电源方案( 高压LED)。
今后室内照明将更关注品质,而在成本因素驱动下,去电源方案逐步会成为可接受的产品,而高压LED充分迎合了去电源方案,但其需要解决的是芯片可靠性需要加强。
5) 国际国内标准进一步完善。
相信随着LED封装技术的不断精进,国内国际上对于LED产品的质量标准也会不断完善。
6) 更高光品质的需求。
主要是针对室内照明,企业会以LED室内照明产品RA达到80为标准,以RA达到90为目标,尽量使照明产品的光色接近普兰克曲线,这样的光才能够均匀、无眩光。
显示屏未来的封装大趋势
过去显示屏的封装有直插式、SMD 与COB三个主流方向,但是随着小间距的要求越来越多,COB会越来越是未来的主流。直插式与SMD封装工艺在固晶焊线方面与COB封装没有区别,它最大的区别在于使用了支架。
大家都知道,支架一般有四个焊腿,需要通过SMT焊接到PCB板上。因此COB封装工艺相比直插式和SMD封装工艺最大的不同之处在于单灯省去了一个支架,因此也就节省了灯珠面过回流焊机的表贴焊接处理工艺。为什么COB会是未来技术的主流呢?以下是显示屏用的COB优势:
1)超轻薄:可根据客户的实际需求,采用厚度从0.4-1.2mm厚度的PCB板,使重量最少降低到原来传统产品的1/3,可为客户显着降低结构、运输和工程成本。 2)防撞抗压:COB产品是直接将LED芯片封装在PCB板的凹形灯位内,然后用环氧树脂胶封装固化,灯点表面凸起成球面,光滑而坚硬,耐撞耐磨。 3)大视角:COB封装采用的是浅井球面发光,视角大于175度,接近180度,而且具有更优秀的光学漫散色浑光效果。 4)可弯曲:可弯曲能力是COB封装所独有的特性,PCB的弯曲不会对封装好的LED芯片造成破坏,因此使用COB模块可方便地制作LED弧形屏,圆形屏,波浪形屏。是酒吧、夜总会个性化造型屏的理想基材。可做到无缝隙拼接,制作结构简单,而且价格远远低于柔性线路板和传统显示屏模块制作的LED异形屏。 5)散热能力强:COB产品是把灯封装在PCB板上,通过PCB板上的铜箔快速将灯芯的热量传出,而且PCB板的铜箔厚度都有严格的工艺要求,加上沉金工艺,几乎不会造成严重的光衰减。所以很少死灯,大大延长了LED显示屏的寿命。 6)耐磨、易清洁:灯点表面凸起成球面,光滑而坚硬,耐撞耐磨;出现坏点,可以逐点维修;没有面罩,有灰尘用水或布即可清洁。 7)全天候优良特性:采用三重防护处理,防水、潮、腐、尘、静电、氧化、紫外效果突出;满足全天候工作条件,零下30度到零上80度的温差环境仍可正常使用。由上面的趋势来看,由于SMD需要解决焊脚问题,一个灯珠有四个焊脚,那么随着显示屏的密度更高,单位平方米中所使用的灯珠将会更多,焊脚将会越来越密,这个问题不解决,对于表贴来说小型化是一个非常大的挑战,COB把支架这一部分略过,几百万个焊点的难题全部被抛之脑后,小型化做起来更轻松。所以未来的显示屏技术会往COB方向走是毋庸置疑的,COB封装最大的技术优势就是直接在PCB板上进行封装,不受灯珠的限制,所以,对于COB来说点间距这个说法并不科学,理论上来说,COB封装想要达到高密,是非常容易的,借用行业人士一句话来说,COB封装就是为小间距量身打造的,如果RGB的倒装芯片逐渐往小芯片技术方向走,甚至未来的Mini LED甚至Micro LED都会往这个技术趋势做显示产品。
Mini LED与Micro LED
Mini LED是指芯片尺寸约在100微米左右的LED,Mini LED的尺寸介于传统LED与Micro LED之间,目前主要应用在超小间距显示屏与传统LED背光基础上的改良版本的mini LED背光。而Micro LED是LED微缩化和矩阵化技术,简单来说,就是将LED背光源进行薄膜化、微小化、阵列化,可以让LED发光单元像素小于100微米,每个RGB次像素发光单元在20微米到30微米之间,与OLED一样能夠实现每個图元单独定制,单独驱动发光的自发光显示技术。如果从结构原理上来看, Micro LED结构更简单,但是它最大的难题就是众所周知的巨量转移,而LED的微小化技术也是难题之二,当然如何保证良率接近100%更是Micro LED最大的挑战,比方说, 4K级别的Micro LED中尺寸显示器,需要2,488万个以上的RGB三色Micro LED高度集成,而且不能有坏点,难度可想而知,短期内要量产还需要很长的时间。从工艺制程上看,Mini LED相较于Micro LED来说,工艺更接近目前的一般LED,良率更好控制,在显示屏应用上,可以做出解析度非常高的电影屏幕,背光应用上可以搭配软性基板达成高曲面背光的形式,采用局部调光设计,拥有更好的演色性与对比度,能带给液晶面板更為精细的画面,且厚度也趋近OLED,同時具有省电功能。所以,很可能mini LED在未来两到三年会支撑LCD对抗OLED技术,但是随着OLED良率提升与柔性OLED技术的成熟,mini LED背光将会节节败退,而在这三年左右的缓冲期中,Micro LED能否突破技术瓶颈,将良率与成本进行革命性的突破,将关系到LED与OLED最终的胜负,人类的终极显示技术,谁会是最终王者,也许三年后就会有最终的答案。