RF MEMS 封装对确保RF MEMS 通过微型化、集成化来探索新原理、设计新功能元器件与系统、开辟新技术领域和产业这一目标的实现,起着举足轻重的作用。在商用RF MEMS 产品中,封装是最终确定其体积、可靠性、成本的关键技术,期待值极高。封装可以定义为:利用膜技术及微细连接技术将元器件及其它构成要素在框架或基板上布置,固定及连接,引出接线端子,并通过可塑性绝缘介质灌封固定,构成完整的立体结构的工艺[1]。封装具有机械支撑、电气连接、物理保护、外场屏蔽、应力缓和、散热防潮、尺寸过渡、规格化和标准化等多种功能[2]。
RF MEMS 封装大致可以分为圆片级,单片全集成级,MCM 级,模块级,Sip 级等多个层面。圆片级封装给RF MEMS 制作的前、后道工序提供了一个技术桥梁,具有倒装芯片封装与芯片尺寸封装的特点。单片全集成级封装要对一个集成在同一衬底上的微结构和微电路进行密封,使之成为一个可供应用的完整系统产品。MCM 级是将MEMS 和信号处理芯片组装在一个外壳内,采用成熟的淀积薄膜型多芯片组件MCM-D, 混合型多芯片组件MCM-C/D,后膜陶瓷多芯片组件MCM-C 的工艺与结构达到高密度、高可靠性封装。这类封装在小体积、多功能、高密度和提高生产效率方面显示出优势。模块级封装旨在为RF MEMS 设计提供一些模块式的外部接口,一般分为光学接口、流体接口、电学接口,接口数据则由总线系统传输,从而使RF MEMS 能使用统一的、标准化的封装批量生产,减少在封装设备上的投资,降低成本,缩短生产周期。Sip 称为超集成策略,在集成异种元件方面提供了最大的灵活性,适用于RF MEMS 的封装。在目前的通信系统使用了大量射频片外分立单元,无源元件占到射频系统元件数目的80%~90%,占基板面积的70%~80%,这些可MEMS 化来提高系统集成度及电学性能,但往往没有现成的封装可以利用,而SiP 是一种很好的选择,完成整个产品的组装与最后封装[3]。
1 RF MEMS 封装的特殊性和基本要求
1.1 RF MEMS 封装的特殊性
RF MEMS封装形式多是建立在标准化的IC 芯片封装的基础上,但RF MEMS 封装具有和IC 芯片封装显著不同的自身特殊性:
a)应用的专一性
RF MEMS 中通常都有一些精细的可移动结构或悬空结构,封装结构取决于RF MEMS 器件及其用途,对各种不同结构及用途的RF MEMS 器件,其封装设计要因地制宜,与制造技术同步协调,专一性很强。
b)对封装设计的挑战性
多数RF MEMS 封装外壳上需要留有同外界直接相连的非电信号通路,例如,有传递光、磁、热等一种或多种信息的通路。输入信号界面复杂,对芯片钝化和封装保护提出了特殊要求。某些MEMS的封装技术比MEMS还新颖,不仅技术难度大,而且对封装环境的要求也很严格,对封装技术的发展有很大的挑战性。
c)空间性
为给RF MEMS 可活动部分提供足够的可动空间,需要在外壳上刻蚀或留有一定的槽形及其它形状的空间,灌封好的RF MEMS 需要表面上的净空,封装时能提供一个十分有效的保护空腔。
d)防护性
RF MEMS 芯片在完成封装之前,始终对环境的影响极其敏感。RF MEMS 封装的各操作工序:划片、烧结、互连和密封等需要采用特殊的处理方法,提供相应的保护措施。
e)经济性
RF MEMS 封装主要采用定制式研发,现处于初期发展阶段,离系列化、标准化要求尚远。封装在整个产品价格中占有40%~90%的比重,降低封装成本非常重要。
1.2 RF MEMS 封装的基本要求
为了保持 RF MEMS 器件良好的性能,RF MEMS 封装必须遵循一些基本要求,下面分别从气密性、射频性能、热性能、机械性能和封装环境加以说明:
a)气密性:
气密性既是外壳亦是元器件的重要指标之一,气密性不好会使外界水汽、有害离子或气体进入腔内,使器件污染、氧化、失效。(据报道,由于腔体内湿气含量大而导致元器件失效的比例为总失效的26%以上)[4]。所以气密性封装非常重要。
b)射频性能:
封装引起的器件射频性能的变化主要是由于封装在高频时引入了寄生的电感、电容,使阻抗不匹配,从而使器件的性能变差。设计结构应尽量弥补封装引入的寄生效应,提高器件的射频性能。
c)热性能:
由于RF MEMS 器件都是较精细的结构,不能承受很高的温度。一般现在认为不能高于350度[5],这就限制了好多技术的应用。另外,保证封装对RF MEMS器件自身产生的热量进行散热是封装设计必须解决的问题。随着RF MEMS 结构的日益复杂化,封装热设计将显得更加重要。
d)机械性能
RF MEMS 的可靠性问题很大程度上来自封装。RF MEMS 芯片对封装残余应力非常敏感;在封装过程中,热膨胀系数不匹配会引入热应力;机械振动也会产生机械应力,从而使RF MEMS 微结构产生变形。封装后焊接区域的剪切力也是很重要的参数,必须保证封装后的器件在以后的工艺操作中有足够的可靠性。在封装设计时,需要了解应力的变化、分布以及可能引入的残余应力对器件本身的影响,采用合理的工艺避免或减少封装过程中残余应力的产生。
e)封装环境
封装体内的压力和气体都会对器件产生很大的影响。RF MEMS 器件需要在常压的氮气或惰性气体中进行封装,原因是常压下的气体阻尼效应会降低可动结构的机械振动Q 值,提高器件的可靠性。而封装体内外压强的平衡会有效地减少外界的湿气通过封装体的漏洞进入封装体内[6]。
总结RF MEMS 封装的基本要求如表1 所示。

2 RF MEMS 封装研究现状
近年来,RF MEMS 封装越来越受重视。需求促进发展,笔者总结了一下,为了使封装有整体上的发展和适应具体器件的封装要求,研究者都是在封装材料、封装结构、焊接技术、电连接技术和封装先进技术等方面进行研究、选择和改进。
2.1 封装材料
研究封装材料的目的是为了改善封装的气密性、射频性能、热性能、机械性能。
目前比较常用的顶盖材料有陶瓷、玻璃、金属和聚合物。粘结和密封材料有金属和环氧,BCB。陶瓷、金属和玻璃的密封性能比较好,但是跟聚合物比起来,价格较贵。传统的金属封装材料包括Al、Cu、Mo、W、钢以及Cu/W 和Cu./Mo 等,它们各自有热失配、重量、价格、导热性、加工工艺难易、退火温度、平面度和重结晶后的脆性等方面的优缺点,难以应付现代封装的发展。现在开发了很多金属基复合材料,以金属(如Mg、Al、Cu、Ti)或金属间化合物为基体,以颗粒、晶须、短纤维或连续纤维为增强体的一种复合材料。它可以改变增强体的种类、体积分数、排列方法或改变基体合金,改变材料的热物理性能,满足热耗散要求,而且制造灵活,价格低,很有发展前途。
环氧粘接工艺的温度一般为60~120 度,是成本较低、工艺可靠性较好的粘接和密封工艺。环氧粘接的缺点是无法保证气密性,因此对于可靠性要求较高的RF MEMS 开关来说是不适用的。BCB 的制作温度较低(<250 度),高电阻(1019Ωcm),低介电常数(2.65),机械性能好,但气密性也不是很好,焊接时间对BCB影响也比较大。10 分钟,250度焊接的BCB 可称之为近气密封装[8]。用BCB封装的实例如图1 所示[9]。该封装结构采用BCB为连接和密封材料,采用在空气中预加热(120度),再放在所需气体和压强的腔内加热(250度)使BCB回流的粘接工艺,测得的封装后气密性比较好(2×10-9mbar.1/s)。不过无法确定漏气是粘接界面引起还是BCB 层引起。
最近,LCP(liquid crystal polymer)的研究也比较多,它有很多的优点:近似密封、CTE低、可以和金属和半导体匹配、不自燃、可复用、易成形和射频特性好。由于它的介电常数比较低(跟空气相近),所以引起的阻抗不匹配较小,它还可以有多个熔点。LCP封装的尺寸设计也可以比较任意,对器件没什么影响。用LCP封装的实例如图2 所示。该结构采用LCP 作为芯片和顶盖的衬底材料,由于LCP 有多个熔点,中间的粘接材料是采用低熔点的LCP,在较低温度下实现粘接层的融化形成良好的连接。该结构显示频率到40GHz 时,封装对开关几乎没什么影响[10]。
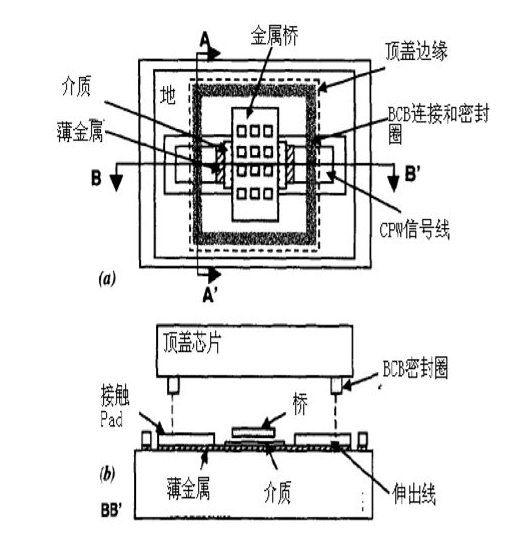
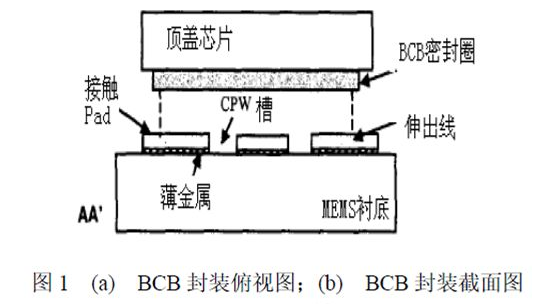
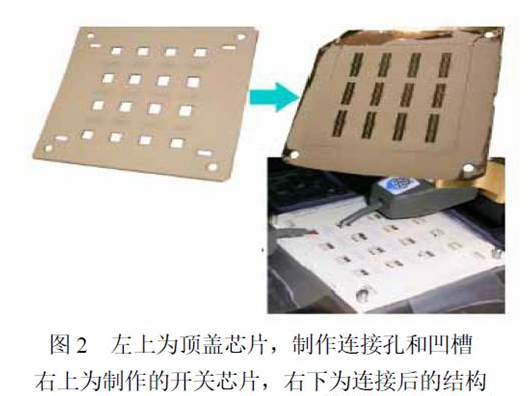
2.2 设计结构
研究设计结构的目的是为了改善封装的射频性能,实现高密度的封装。
一般的封装结构如图3[8]所示。

在0-level 封装低频应用中,一般以焊球高度来形成芯片所需的空间。这样的结构应用于较高频率时,顶盖就会对器件的性能有比较大的影响。可以将顶盖刻蚀形成凹槽来减小这种影响。对CPW 研究封装顶盖凹槽深度的影响(CPW 宽度50μm,间隙27μm,没有失谐时特性阻抗为49Ω,eff ε =4.85),结果如表2 所示。

从上表可以看出,凹槽的深度一般要做到30μm~40μm 时,才能使MEMS 电路的失谐减小到可以接受的程度。
由于0-level封装会形成一定的高度,所以在1-level时焊球必须有相当的厚度,这给工艺带来复杂性,引起的寄生效应也比较大,而且高密度封装希望有较薄的厚度,所以必须尽量减薄顶盖的厚度。薄的顶盖在切割的时候容易引起变形,有工艺使用载片,用一蜡层将顶盖晶片粘于载片上,按照封装顶盖制作过程切割后,将蜡层融化掉(150 度),再将载片机械移除。步骤如图4 所示[11]。
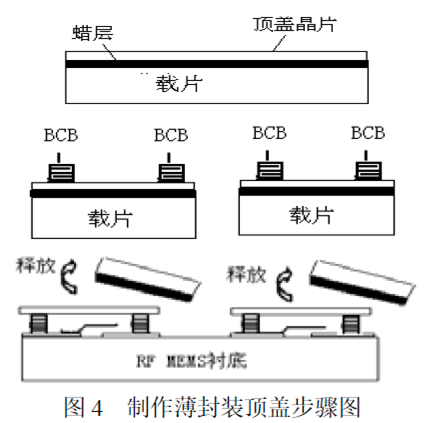
在毫米波时,由于1-level 的焊球引起的寄生电容的影响太大,所以希望能把焊球做得越小越好,这时就必须在连接芯片上开孔,使焊球做得尽可能的小,以减小寄生电容。结构如图5 所示[8]。
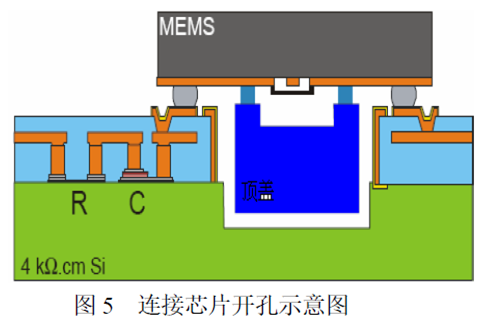
2.3 焊接技术
研究焊接技术是为了改善封装的气密性、热性能和机械性能。
焊接有很多方法,例如:阳极键合、玻璃熔接、局部加热、金属共晶焊等等,其中金属共晶焊是比较常用的方法。这些技术或多或少都会对器件产生不利的影响。首先,多数焊接工艺的高温会驱使玻璃、金或环氧中的液态成分散发到RF MEMS 结构周围,对器件的可靠性造成影响。其次,为了保证密封效果,一般的工艺需要加热到250~500 度,这对于某些MEMS 结构来说是无法承受的。最后,密封焊接技术本身也存在着一些特殊的要求,例如:玻璃阳极键合对圆片表面的平整度和清洁度的要求较高,金-金热压焊对圆片上电镀金环高度的一致性要求较高,等等。
为了缓解高温对RF MEMS 器件的影响,人们开发了局部加热技术,利用电阻加热条在待密封的区域局部加热形成高温,在不影响器件温度的情况下完成封装。如图6 所示[6],这一技术已经在铝/硅-玻璃键合中得以实现,电阻加热条选用多晶硅材料,加热条上依次淀积1000埃氧化硅、500埃氮化硅和1000埃氧化硅,一方面保证绝缘,另一方面防止铝焊料向加热条扩散导致短路;接着淀积5000埃的多晶硅黏附层和2微米的铝焊料层,并刻出接触图形;最后,在加热条上通电,电流46 毫安,局部加热700 度,在0.2Mpa 压强下进行7.5 分钟的热压焊,介质层析出的氧与铝结合为氧化铝,形成牢固的气密性键合。除了可以用铝-玻璃键合,还可以用铟-玻璃键合和PSG-玻璃键合。局部加热技术对于MEMS器件来说是比较理想的密封技术,其技术难题是焊料层对密封腔内的放气问题。
焊料系统可以基于以下方面优化:浸润性、熔点、机械性能、CTE、疲劳寿命、热阻和腐蚀电阻。由于Au-Sn 焊料高的延展性,好的热导性和浸润性,它被广泛应用于倒装焊,An-20%Sn在280度时是很适合MEMS封装的[13]。
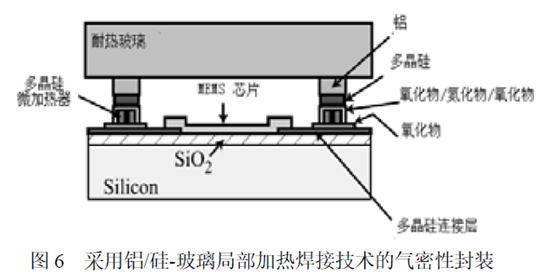
2.4 电连接技术
研究电连接技术是为了改善封装的射频性能、气密性和热性能。
对于信号频率比较低的RF MEMS 器件,一般采用平面式的电连接技术。因为工艺比较简单,可以直接从玻璃底下引出(阳极键合封装),或是用2~3μm 厚的氮化层或氧化层将输入/输出线与金密封环隔离后引出。若是要将这种方法用在较高频时,可以用BCB来作为粘接层,这样信号线直接从BCB下通过,不过这种方法有密封性的问题。一般的平面类的电连接技术都会有寄生效应这个问题,因为引出线需要埋置在绝缘层中,这改变了阻抗特性,因此要提供匹配网络。另外,绝缘层要淀积在金属层上面,会造成不共面现象。
很多研究致力于设计新的电连接方式,以减少寄生效应。有设计将信号线采用埋层的方法输入输出,如图7 所示[14]。
也可以采用过孔技术来实现高频段的信号传输,为了适应高频需要,它们一般加工在较薄的圆片上,长度较短,可以用致密的金或铜填充确保气密性。在DC-6GHz 的应用中,还可以采用顶层圆片长过孔的方法,如图8 所示[15]。
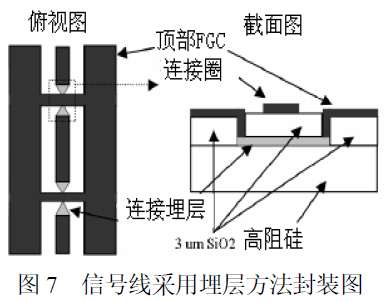
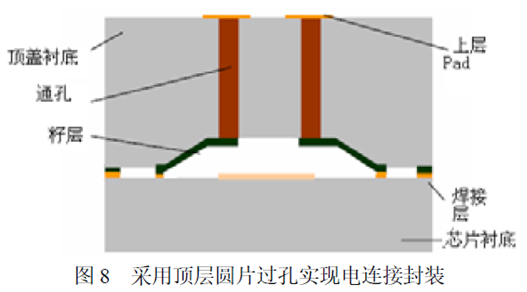
还有一种双层FGC的连接方法,这种工艺采用过孔将双层FGC连接,使信号线和密封圈完全隔开,给焊接带来了方便。寄生效应也明显改善。如图9所示[7]。
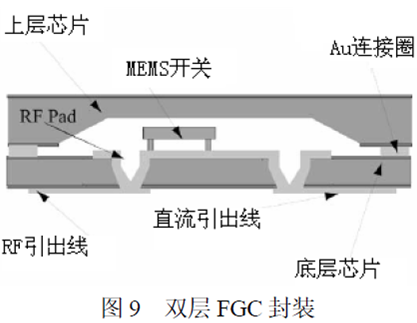
以上几种在高频时的封装电连接方法都存在着增加了工艺复杂性的缺点。
2.5 封装先进技术
目前研究的比较多的是 BGA,FC,CSP 技术。
2.5.1 BGA (Ball Grid Array)
将芯片装在底板上,芯片的压焊块与底板上的电互连图形实现电连接,各压焊块的节距十分小,无法达到PCB板焊接所需的节距大小。传统的引线框技术从这些焊点处沿二维平面向四周呈蛛网状走线,实现与封装引脚的电连接,这种方法十分浪费空间。BGA通过穿过底板的电通孔和底面的电互连图形,将底板上的节距很小的焊点再分布到底板底面节距较大的焊球阵列上。这样,BGA 用封装的部分或全部底面空间引出引脚,面积利用率高。结构如图10 所示[12]。
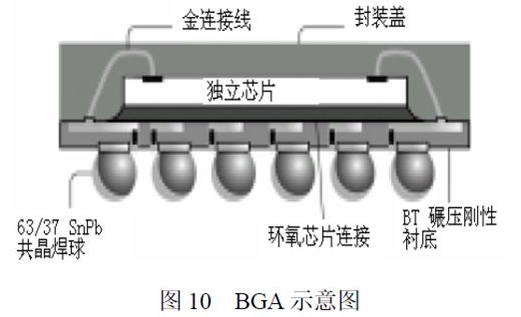
BGA有引脚多,电源、功能相应增强;信号传输延时小,适应频率提高;噪声和串扰减少,电路可靠性提高;FC芯片背面热沉技术,芯片散热功能提高等优点。但也有对PCB板的布线要求提高,对湿度敏感,不可视性,难以保证平面化,成本高等缺点。
2.5.2 FC(Flip Chip)
FC是不用引线,倒装芯片,将芯片与底板上需要电连接的地方对准,用熔焊法,热压焊法,导电胶粘接法等方法进行电连接的一种封装技术。如图11 所示[12]。为了消除芯片的热应力和机械应力,常用underfill技术进行应力缓冲。FC最早提出来的时候,是直接作为BareChip封装形式提出的,因为芯片焊盘节距与PCB板节距相仿时,可以直接实现芯片与PCB板的FC组装;但在集成度高、芯片焊盘多,节距很小的时候, 就需要用PGA,BGA,CSP等技术间接地应用FC原理,完成封装。
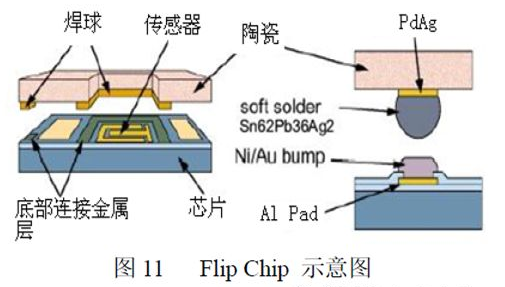
FC有面积小,多引脚,无引线连接,寄生效应小,键合一次完成,Underfill 工艺减弱热应力,可靠性增强,成本低等优点。FC的缺点是凸点技术成品率不高,组装准确性不高,对底板要求高,可测试性差,加工困难,周期长等。
2.5.3 CSP (Chip Size Package)
CSP,即芯片尺寸封装,规定为封装尺寸不超过芯片尺寸的1.2倍,面积不超过芯片的1.4倍。严格地说,CSP只是一种封装思路,而不是具体的实现方式。根据CSP的封装思路,不同的厂家提出不同的实现方案,有的用BGA技术实现,也有用PLCC技术实现。它们的结构完全不同,相同点只在于都符合CSP的封装要求。目前CSP一般分为传统引线框形式、硬质内插板型、软质内插板型和晶圆尺寸封装四个类型,如图12所示[12]。WLP(晶圆尺寸封装)级CSP(WLCSP)是目前最被看好的封装技术。
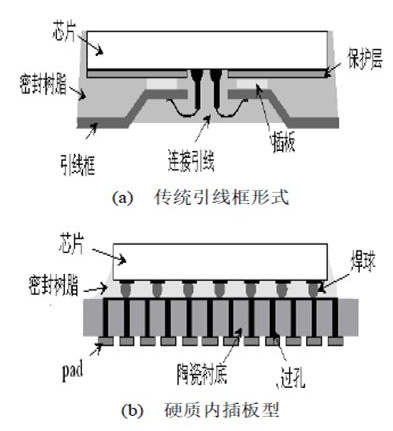
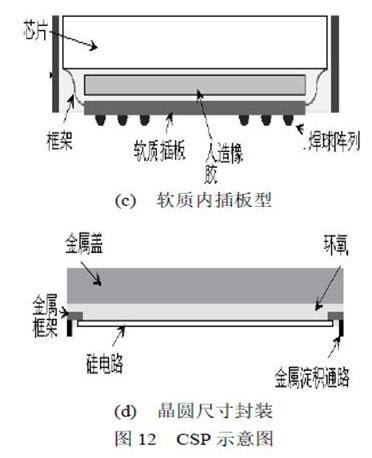
总的来说,CSP具有裸片组装的尺寸优势和封包技术的可靠性优势,因为大部分CSP 采用的是FC+BGA 工艺,所以它基本上也综合了FC和BGA的优点。当然缺点也伴随其中。面积小、薄、轻巧是CSP的最大优点,封装小、电连接短、电性能好、可测试性比较好、与SMT技术兼容都是CSP的优点。但也有技术不统一、规模小、成本高、产量少、可靠性不高的缺点。
3 总结
RF MEMS 封装可以分为圆片级、单片全集成级、MCM 级、模块级、Sip 级等多个层面。它具有与IC封装显著不同的自身特殊性:应用专一性、对封装设计的挑战性、空间性、防护性、经济性。RF MEMS 封装必须满足气密性、热性能、机械性能、高频性能、封装环境等方面的一些基本要求。本文从这些基本要求入手,分别介绍了RF MEMS封装在封装材料、封装结构、焊接技术、电连接技术和封装新技术等方面的研究与发展现状。