摘要:硅片背面磨削减薄工艺中,机械磨削使硅片背面产生损伤,导致表面粗糙,且发生翘曲变形。分别采用粗磨、精磨、精磨后抛光和精磨后湿法腐蚀等四种不同背面减薄方法对15.24cm(6英寸)硅片进行了背面减薄,采用扫描电子显微镜对减薄后的硅片表面和截面形貌进行了表征,用原子力显微镜测试了硅片表面的粗糙度,用翘曲度测试仪测试了硅片的翘曲度。结果表明,经过粗磨与精磨后的硅片存在机械损伤,表面粗糙且翘曲度大,粗糙度分别为0.15和0.016μm,翘曲度分别为147和109μm;经过抛光和湿法腐蚀后的样品无表面损伤,粗糙度均小于0.01μm,硅片翘曲度低于60μm。
硅片背面减薄是一步重要的硅片制造工艺,目的是去除硅片背面多余材料,以有效减小硅片封装体积,降低热阻,提高器件的散热性能,降低封装后芯片因受热不均而开裂的风险,提高产品可靠性;同时,减薄后的芯片机械性能与电气性能也得到显著提高。硅片背面减薄技术有很多种,如磨削、抛光、干式抛光、电化学腐蚀、湿法腐蚀、等离子辅助化学腐蚀和常压等离子腐蚀等。其中硅片磨削减薄技术是一种效率高、成本较低的减薄技术,已得到广泛应用。该技术通过砂轮在硅片表面旋转施压、损伤、破裂、移除而实现硅片减薄。工艺中不可避免引入损伤,降低器件可靠性和稳定性。抛光工艺采用硅片与抛光头之间相对运动来平坦化硅片表面,在硅片和抛光头之间有磨料;湿法化学腐蚀是一种通过腐蚀液与硅片发生化学反应实现硅片减薄的工艺技术,常用的腐蚀液有酸性腐蚀液(如硝酸、冰乙酸与氢氟酸)和碱性腐蚀(如KOH溶液[1])。
本文以15.24cm(6英寸)硅片背面减薄为例,通过对经过磨削、磨削后抛光与磨削后湿法腐蚀工艺后硅片的损伤、表面粗糙度与翘曲度的分析,优化硅片背面减薄技术。
取4片6英寸单晶硅片,硅片厚度为675μm,正面贴保护膜,保护膜厚度为140μm;采用方达科技单片研磨机对硅片进行磨削减薄加工,加工选用325#-DISCO砂轮,砂轮粒度为40~60μm,将4片6英寸硅片减薄140μm至535μm,取出其中1个样品,编号为1#;接着采用方达单面研磨机对余下3个样品进行精磨削加工,加工选用2000#-DISCO砂轮,砂轮粒度为4~6μm,去除硅片厚度为30μm,取出其中1个样品,编号为2#;对余下的两个样品,一个采用方达科技单面抛光机进行化学机械抛光40min,编号为3#,另一个用湿法化学腐蚀方式减薄,腐蚀时间5min,编号为4#。湿法腐蚀采用硝酸、冰乙酸和氢氟酸混合液腐蚀液,体积比为硝酸∶冰乙酸∶氢氟酸=5∶4∶1,反应原理如下[2]:

完成上述减薄工艺后,去除样品正面保护膜,清洗,然后采用Mitotuyo厚度测试仪测试样品厚度,用翘曲度测试仪测试样品翘曲度,采用FEG450扫描电子显微镜观察样品表面和截面形貌,用原子力显微镜测试样品粗糙度。
2.1表面形貌分析
图2是减薄后样品表面扫描电子形貌图(SEM)。由图可见,1#样品表面粗糙、起伏大,存在凸起与凹坑;2#样品表面存在大量细小划痕。原子力显微镜测试得出1#样品与2#表面粗糙度Ra分别为0.15和0.016μm。
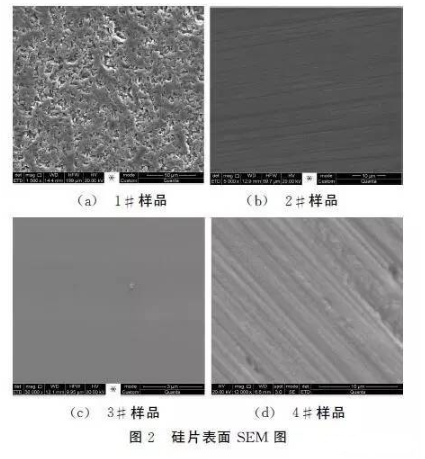
单晶硅材料的原子在晶体内部按照金刚石结构周期性排列,硅片背面磨削减薄是一种物理损伤工艺,砂轮的磨削会破坏硅原子内部的周期性排列顺序,在硅片表面产生机械损伤。对比图2(a)与图2(b)可知,样品表面形貌和表面粗糙度与研磨所用砂轮有关,砂轮粒度越小,硅片表面越平整,粗糙度越小。
图2(c)和图2(d)分别为3#与4#样品表面形貌图,对比两图可见,化学机械抛光后样品表面平整,没有磨削划痕,湿法腐蚀后样品表面依然可见砂轮磨削留下的划痕。3#与4#样品表面粗糙度Ra分别为0.001和0.008μm。化学机械抛光工艺是一种全局性平坦化工艺,由上述结果可知,抛光工艺有效地改善了硅片表面形貌;腐蚀工艺后样品表面粗糙度降低,结合酸性湿法腐蚀工艺是一种各向同性腐蚀工艺[3],样品表面损伤与凸起部分被优先腐蚀,可见湿法腐蚀可改善硅片表面形貌。4个样品表面粗糙度Ra见表2所示。

2.2截面形貌分析
图3为样品截面形貌图(SEM),可见1#样品截面粗糙,截面存在裂纹,2#样品截面平直,有微裂纹。由图可知,样品截面损伤层厚度分别为5.382与1.115μm。
硅片磨削减薄是一种物理性损伤工艺,根据Hadamovsky提出的损伤层模型[4],机械研磨减薄工艺后,基体硅之上存在着损伤层,损伤层自上而下分为多层结构。结合上述实验可知,损伤层厚度与研磨硅片砂轮粒度有关,砂轮粒度越大,磨削产生的损伤层越大,硅片表面越粗糙。3#与4#样品截面图如图3(c)与图3(d)所示,样品截面无损伤层,结合上文可知,抛光工艺和湿法腐蚀工艺去除了样品表面的机械损伤,减薄后样品厚度以及表面损伤层厚度如表3所示。表3中还列出了样品的翘曲度,由表中可知,样品翘曲度与表面损伤层厚度相关,如图4所示,损伤层厚度越大,翘曲度也越大。硅片表面的机械损伤破坏了硅片晶体结构,降低硅片强度,增大硅片在传递过程中碎片率,影响后续工艺的可靠性与稳定性,降低了产品成品率。抛光工艺和湿法腐蚀不仅可以去除硅片表面损伤层,还降低了硅片翘曲度,有效提高减薄后硅片质量,这对提高生产线成品率,拓宽元器件使用条件,提高元器件使用性能,延长使用寿命等都具有极其重要的意义。
硅片背面机械研磨减薄是一种物理损伤工艺,减薄会在硅片表面引入机械损伤。文中对比分析了粗磨、精磨、抛光和湿法腐蚀工艺后硅片表面与截面形貌,并且测试了硅片厚度、粗糙度和翘曲度,结合理论分析,得到结论如下:机械研磨减薄工艺中硅片表面形貌和损伤层厚度和研磨减薄砂轮粒度有关,砂轮粒度越大,硅片表面越不平整,粗糙度也越大,损伤层厚度越大。采用粗磨与精磨结合减薄的方法,可以改善硅片表面形貌,降低硅片表面损伤层厚度;湿法腐蚀与抛光工艺可以改善硅片表面形貌,去除硅片减薄中产生的机械损伤,抛光工艺可以得到粗糙度更低的硅片表面,速率较慢,湿法腐蚀工艺效率高,表面较粗糙;减薄硅片的翘曲度与损伤层厚度有关,损伤层厚度越大,硅片翘曲度越大。实际工艺中,结合器件需求,可以采用先分段研磨,再抛光或湿法腐蚀的方法,得到高质量的减薄硅片。