磁控溅射
磁控溅射是物理气相沉积(Physical Vapor Deposition,PVD)的一种。一般的溅射法可被用于制备金属、半导体、绝缘体等多材料,且具有设备简单、易于控制、镀膜面积大和附着力强等优点,而上世纪 70 年代发展起来的磁控溅射法更是实现了高速、低温、低损伤。因为是在低气压下进行高速溅射,必须有效地提高气体的离化率。磁控溅射通过在靶阴极表面引入磁场,利用磁场对带电粒子的约束来提高等离子体密度以增加溅射率。
磁控溅射定义
在二极溅射中增加一个平行于靶表面的封闭磁场,借助于靶表面上形成的正交电磁场,把二次电子束缚在靶表面特定区域来增强电离效率,增加离子密度和能量,从而实现高速率溅射的过程。
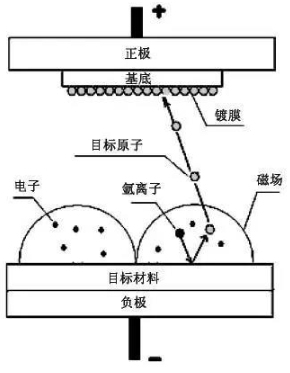
磁控溅射原理
磁控溅射的工作原理是指电子在电场E的作用下,在飞向基片过程中与氩原子发生碰撞,使其电离产生出Ar正离子和新的电子;新电子飞向基片,Ar离子在电场作用下加速飞向阴极靶,并以高能量轰击靶表面,使靶材发生溅射。在溅射粒子中,中性的靶原子或分子沉积在基片上形成薄膜,而产生的二次电子会受到电场和磁场作用,产生E(电场)×B(磁场)所指的方向漂移,简称E×B漂移,其运动轨迹近似于一条摆线。若为环形磁场,则电子就以近似摆线形式在靶表面做圆周运动,它们的运动路径不仅很长,而且被束缚在靠近靶表面的等离子体区域内,并且在该区域中电离出大量的Ar 来轰击靶材,从而实现了高的沉积速率。随着碰撞次数的增加,二次电子的能量消耗殆尽,逐渐远离靶表面,并在电场E的作用下最终沉积在基片上。由于该电子的能量很低,传递给基片的能量很小,致使基片温升较低。磁控溅射是入射粒子和靶的碰撞过程。入射粒子在靶中经历复杂的散射过程,和靶原子碰撞,把部分动量传给靶原子,此靶原子又和其他靶原子碰撞,形成级联过程。在这种级联过程中某些表面附近的靶原子获得向外运动的足够动量,离开靶被溅射出来。
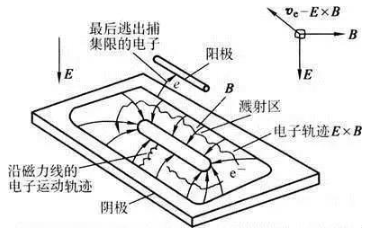
磁控溅射种类
磁控溅射包括很多种类。各有不同工作原理和应用对象。但有一共同点:利用磁场与电场交互作用,使电子在靶表面附近成螺旋状运行,从而增大电子撞击氩气产生离子的概率。所产生的离子在电场作用下撞向靶面从而溅射出靶材。
靶源分平衡和非平衡式,平衡式靶源镀膜均匀,非平衡式靶源镀膜膜层和基体结合力强。平衡靶源多用于半导体光学膜,非平衡多用于磨损装饰膜。磁控阴极按照磁场位形分布不同,大致可分为平衡态和非平衡磁控阴极。平衡态磁控阴极内外磁钢的磁通量大致相等,两极磁力线闭合于靶面,很好地将电子/等离子体约束在靶面附近,增加碰撞几率,提高了离化效率,因而在较低的工作气压和电压下就能起辉并维持辉光放电,靶材利用率相对较高,但由于电子沿磁力线运动主要闭合于靶面,基片区域所受离子轰击较小.非平衡磁控溅射技术概念,即让磁控阴极外磁极磁通大于内磁极,两极磁力线在靶面不完全闭合,部分磁力线可沿靶的边缘延伸到基片区域,从而部分电子可以沿着磁力线扩展到基片,增加基片区域的等离子体密度和气体电离率.不管平衡非平衡,若磁铁静止,其磁场特性决定一般靶材利用率小于30%。为增大靶材利用率,可采用旋转磁场。但旋转磁场需要旋转机构,同时溅射速率要减小。旋转磁场多用于大型或贵重靶。如半导体膜溅射。对于小型设备和一般工业设备,多用磁场静止靶源。用磁控靶源溅射金属和合金很容易,点火和溅射很方便。这是因为靶(阴极),等离子体,和被溅零件/真空腔体可形成回路。但若溅射绝缘体如陶瓷则回路断了。于是人们采用高频电源,回路中加入很强的电容。这样在绝缘回路中靶材成了一个电容。但高频磁控溅射电源昂贵,溅射速率很小,同时接地技术很复杂,因而难大规模采用。为解决此问题,发明了磁控反应溅射。就是用金属靶,加入氩气和反应气体如氮气或氧气。当金属靶材撞向零件时由于能量转化,与反应气体化合生成氮化物或氧化物。磁控反应溅射绝缘体看似容易,而实际操作困难。主要问题是反应不光发生在零件表面,也发生在阳极,真空腔体表面,以及靶源表面。从而引起灭火,靶源和工件表面起弧等。德国莱宝发明的孪生靶源技术,很好的解决了这个问题。其原理是一对靶源互相为阴阳极,从而消除阳极表面氧化或氮化。冷却是一切源(磁控,多弧,离子)所必需,因为能量很大一部分转为热量,若无冷却或冷却不足,这种热量将使靶源温度达一千度以上从而溶化整个靶源。